研究者・工場向けオゾン装置メーカーのエコデザイン株式会社。オゾンを現場で安全かつ効果的に使用する方法をアドバイスします。
TEL 0493-72-6161 営業時間 平日9:00~18:00
研究者・工場向けオゾン装置メーカーのエコデザイン株式会社。オゾンを現場で安全かつ効果的に使用する方法をアドバイスします。
TEL 0493-72-6161 営業時間 平日9:00~18:00
フォトリソ工程の最終スプレー洗浄においてオゾン水を使用し、洗浄後基板表面の有機物残渣をXPSにて測定、オゾン水洗浄の効果を検証する。
| 使用オゾン発生器 | 研究開発用オゾン発生器 ED-OG-R4(旧ED-OGM-1) |
| 洗浄水圧力 | 0.1MPa |
| O2ガス圧力 | 0.2MPa |
| O2ガス流量 | 0.5l/min |
| オゾン発生器電流値 | 1A |
| オゾン発生器冷却水温度 | 27℃ |
| オゾン濃度 | 130g/Nm3 |
| オゾン発生量 | 6g/hr |
基板上にアルミ成膜
→レジスト塗布(54cp)
→プリベーク(恒温槽110℃,5min)
→剥離液槽(2min)
→IPA洗浄槽(2min)
→純水洗浄槽(2min)
→最終スプレー洗浄
| 基板No. | 洗浄方法 | 洗浄時間 |
| 1 | リファレンス | - |
| 2 | 通常洗浄 | 20sec |
| 3 | オゾン水 | 20sec |
| 4 | オゾン水洗浄 | 40sec |
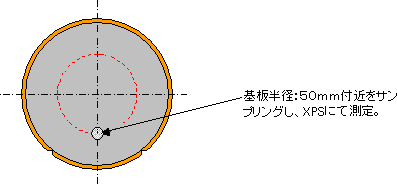
C 1sスペクトル(有機物残渣量)
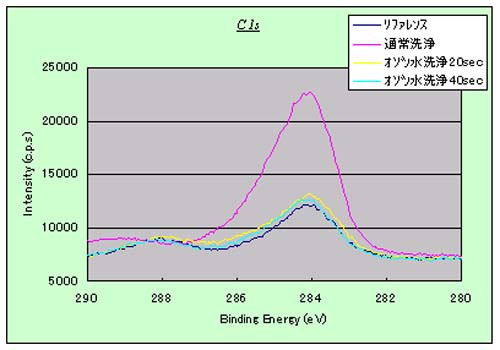
Al 2pスペクトル(アルミ膜表面状態)
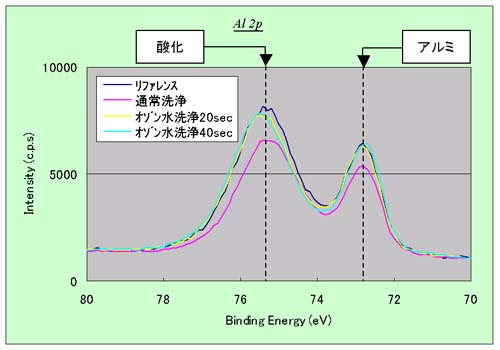
C 1sスペクトル (有機物残渣量 面積比)

通常洗浄では、有機物の残渣が多い。(主に剥離液、レジスト)
オゾン水洗浄を20sec実施することで、ほぼリファレンスレベルまで有機物残渣が減少している。(40secにて更に残渣が減少している)
アルミの酸化に関しても、リファレンスレベルとほぼ同等であり、40secの洗浄ではアルミ膜に対する影響は見られなかった。